產(chǎn)品介紹:
隨著芯片中晶體管的數(shù)量的增加���,硅通孔封裝(Through Silicon Via, TSV)的垂直堆疊在半導(dǎo)體器件領(lǐng)域突破了傳統(tǒng)二維集成的瓶頸。通過三維集成���,硅通孔TSV技術(shù)近年來得到了廣泛應(yīng)用 �����,其中通孔填充是電阻率和電容的關(guān)鍵過程���,但是硅通孔TSV的縱橫比很高,普通電鍍或?yàn)R射由于其物理和化學(xué)工藝極限�,無法實(shí)現(xiàn)完全填充。而且通過濺射和電鍍的工藝�,硅基板需要經(jīng)過生長(zhǎng)SiO2層,需要通過磁控濺射在具有SiO2層的襯底上沉積由Ti和Cu組成的金屬種子層然后再進(jìn)行電鍍��,整個(gè)流程長(zhǎng)�,耗時(shí)耗電,設(shè)備投入大成本高��。
百柔新材通過開發(fā)具有高導(dǎo)電率的塞孔銅漿通過刮刀壓力的方式將導(dǎo)電銅漿刮入硅通孔����,從而實(shí)現(xiàn)高厚徑比的硅通孔TSV金屬化,可以加工25-150um硅通孔TSV過孔金屬化����。為半導(dǎo)體封裝載板客戶提供硅通孔TSV過孔金屬化代工服務(wù)。也可以為客戶定制和提供塞孔銅漿����,以實(shí)現(xiàn)硅通孔TSV金屬化飽滿填充�。經(jīng)過銅漿塞孔后的TSV能夠使芯片在三維方向堆疊��,通過垂直互連減小互聯(lián)長(zhǎng)度�����,減小信號(hào)延遲���,降低芯片的電容和電感����,實(shí)現(xiàn)芯片間的低功耗高速通訊����,增加寬帶和實(shí)現(xiàn)器件集成的小型化,是公認(rèn)的第四代封裝互連技術(shù)����。
?
工藝流程:
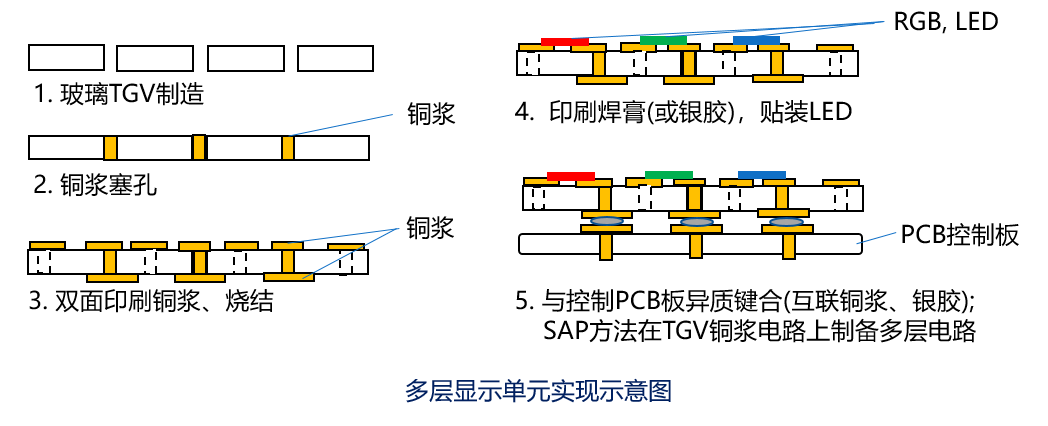
工藝優(yōu)勢(shì):
§ 設(shè)備投入少�,減少了傳統(tǒng)濺射和電鍍大型設(shè)備和資金投入;
§ 工藝簡(jiǎn)單����,通過模具和物理壓力的方式將銅漿等金屬漿料實(shí)現(xiàn)硅通孔TSV金屬化填滿���;
§ 結(jié)合力好,硅通孔TSV金屬漿料中含有玻璃粉體��,提高了金屬漿料與硅基材的結(jié)合力���;
§ 可以實(shí)現(xiàn)高厚徑比的硅通孔TSV金屬化難題 ���,最大塞孔厚徑比高達(dá)20:1;
§ 制程簡(jiǎn)單���,僅僅印刷+燒結(jié)+研磨三個(gè)步驟即可實(shí)現(xiàn)�����。
?
工藝可靠性:
§ 耐化學(xué)腐蝕��,耐熱應(yīng)力����,可焊性良好��;
§ 后制程可靠性穩(wěn)定,可蝕刻��、表面處理����;
§ 低粗糙度:Ra<0.5μm;
§ 高附著力:>3N/mm���;
§ 300℃以下熱沖擊����,附著力穩(wěn)定���;
§ 1000個(gè)熱循環(huán)��,附著力穩(wěn)定����。
?
加工能力:
?

?
應(yīng)用場(chǎng)景:
硅通孔技術(shù)TSV是一項(xiàng)高密度封裝技術(shù)�,正在逐漸取代目前工藝比較成熟的引線鍵合技術(shù),被認(rèn)為是第四代封裝技術(shù)���。硅通孔技術(shù)TSV可以通過垂直互連減小互聯(lián)長(zhǎng)度����,減小信號(hào)延遲�,降低電容/電感,實(shí)現(xiàn)芯片間的低功耗���,高速通訊�����,增加寬帶和實(shí)現(xiàn)器件集成的小型化�����。廣泛應(yīng)用于射頻���、存儲(chǔ)、通訊等芯片的三維封裝領(lǐng)域��。在硅通孔TGV的塞孔銅漿可以與封裝基板或PCB板等的金屬實(shí)現(xiàn)異質(zhì)互聯(lián)��,從而實(shí)現(xiàn)多維封裝�。
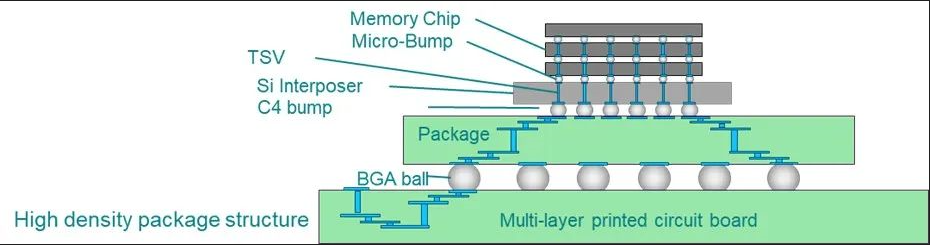
加工效果:
 ?
?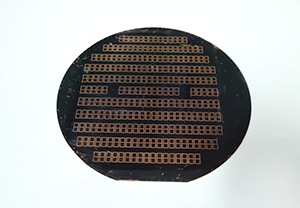 ?
?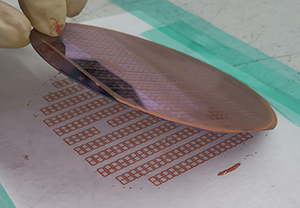
 ?
? ?
?